第三代半导体也称为宽禁带半导体,不同于传统的半导体主要赖硅晶圆,它在材料层面上实现了更新。而与第一代、第二代半导体并非替代关系,而是形成互补,三者特性各异、用途不同。 具体来看,第一代半导体材料以硅(Si)和锗(Ge)为主,是CPU处理器等集成电路主要运用的材料;第二代半导体包括砷化镓(GaAs)、磷化铟(InP)等,目前手机所使用的关键通信芯片都采用这类材料制作。 第三代半导体材料主要是以碳化硅(SiC)、氮化镓(GaN)、氧化锌(ZnO)、金刚石、氮化铝(AlN)为代表的宽禁带半导体材料。在通信、汽车、高铁、卫星通信、航空航天等应用场景中有优势。其中,碳化硅、氮化镓的研究和发展更为成熟。 
主流SiC大厂扩产计划


虽然在SiC市场上,IDM(集成器件制造商)占据主导地位,SiC代工公司也不甘落后,希望能够复制成功的硅代工厂的模式。德国X-Fab、英国Clas-SiC(150mm)、韩国YES POWERTECHNIX(YPT)以及中国台湾的汉磊(Episil)、厦门三安(SANAN)、芜湖启迪(TUS SEMI)都希望从中分到一杯羹。
虽然这些SiC大厂积极扩产,但自2009年纽约州立大学和道康宁公司在150 mm SiC单晶生长取得了重大突破后,全世界SiC产业一直在150 mm产业方向发展。多年来突破200mm、实现大直径的无缺陷或低缺陷SiC晶体生长的却是凤毛麟角,真的这么难吗? 包括SiC在内的第三代半导体产业链包括包括衬底→外延→设计→制造→封装。其中,衬底是所有半导体芯片的底层材料,起到物理支撑、导热、导电等作用;外延是在衬底材料上生长出新的半导体晶层,这些外延层是制造半导体芯片的重要原料,影响器件的基本性能;设计包括器件设计和集成电路设计,其中器件设计包括半导体器件的结构、材料,与外延相关性很大;制造需要通过光刻、薄膜沉积、刻蚀等复杂工艺流程在外延片上制作出设计好的器件结构和电路;封装是指将制造好的晶圆切割成裸芯片。
SiC器件成本高的一大原因就是SiC衬底制造困难。数据显示,衬底成本大约占晶片加工总成本的50%,外延片占25%,器件晶圆制造环节20%,封装测试环节5%。SiC衬底不止贵,生产工艺还复杂,与硅相比,SiC很难处理。 合肥鑫晟光电科技有限公司 设备与工艺工程师 @石大小生 在其知乎专栏上分析了SiC生产的两个难点,即衬底和外延生长。
与传统的单晶硅使用提拉法制备不同,目前规模化生长SiC单晶主要采用物理气相输运法(PVT)或籽晶的升华法。这也就带来了SiC晶体制备的两个难点: 1、 生长条件苛刻,需要在高温下进行。一般而言,SiC气相生长温度在 2300℃以上,压力 350MPa,而硅仅需 1600℃左右。高温对设备和工艺控制带来了极高的要求,生产过程几乎是黑箱操作难以观测。如果温度和压力控制稍有失误,则会导致生长数天的产品失败。 2、 生长速度慢。PVT 法生长SiC的速度缓慢,7 天才能生长 2cm 左右。而硅棒拉晶 2-3 天即可拉出约 2m 长的 8 英寸硅棒。 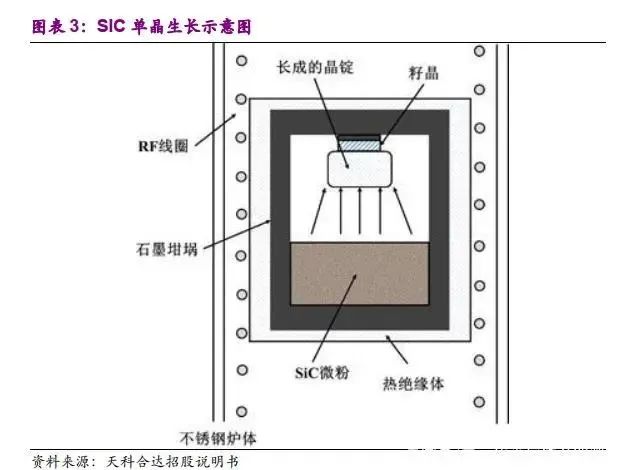
碳化硅生长炉的技术指标和工艺过程中的籽晶制备、生长压力控制、温度场分布控制等因素,决定了单晶质量和主要成本
另一方面,SiC存在 200 多种晶体结构类型,其中六方结构的 4H 型(4H-SiC)等少数几种晶体结构的单晶型SiC才是所需的半导体材料,在晶体生长过程中需要精确控制硅碳比、生长温度梯度、晶体生长速率以及气流气压等参数,否则容易产生多晶型夹杂,导致产出的晶体不合格。 PVT法生长的SiCk单晶一般是短圆柱状,柱状高度(或长度)在20 mm以内,需要通过机械加工整形、切片、研磨、抛光等化学机械抛光和清洗等工艺,才能成为器件制造前的衬底材料。这一机械、化学的制造过程普遍存在着加工困难、制造效率低、制造成本高等问题。SiC单晶加工关注点是晶片不仅具备良好的几何形貌,如总厚度变化、翘曲度、变形,而且具备较高的晶片表面质量(微粗糙度、划伤等)。此外,还要考虑单晶加工的效率和成本问题,这也就给SiC衬底制备提出很大的挑战。 单晶的生长缺陷,主要是SiC 晶片大面积应用中的螺旋位错(称为微管)。目前先进的技术指标是直径100 mm以上的SiC,其微管缺陷密度小于1 每平方厘米。150 mm的SiC材料制备技术,2014年国内已经取得了突破。但规模化生产制造SiC晶片,达到低微管密度或零缺陷质量还存在一些技术工艺问题。 SiC器件制造必须要经过外延步骤,外延质量对器件性能影响很大。SiC基器件与传统的硅器件不同,SiC衬底的质量和表面特性不能满足直接制造器件的要求,因此在制造大功率和高压高频器件时,不能直接在SiC衬底上制作器件,而必须在单晶衬底上额外沉积一层高质量的外延材料,并在外延层上制造各类器件,目前效率也比较低。另外SiC的气相同质外延一般要在 1500℃以上的高温下进行。由于有升华的问题,温度不能太高,一般不能超过 1800℃,因而生长速率较低。 我们前面也提到,SiC是世界上硬度排名第三的物质,不仅具有高硬度的特点,高脆性、低断裂韧性也使得其磨削加工过程中易引起材料的脆性断裂从而在材料表面留下表面破碎层,且产生较为严重的表面与亚表层损伤,影响加工精度。所以在研磨、锯切和抛光阶段,挑战也非常大,其加工难主要体现在: (2)化学稳定性高,几乎不与任何强酸或强碱发生反应; 一句话就是——SiC衬底的划切非常棘手,并且晶圆尺寸越大越棘手。据“半导体封装工程师之家”介绍,目前,用于制作电子器件的SiC晶圆主要有 2 种: 1、N 型导电晶圆厚度 150~350 μm,电阻率0.010~0.028 Ω·cm 2 ,主要应用于发光二极管、电力电子行业的功率器件; 2、高纯半绝缘晶圆厚度50~100 μm,电阻率 1×10 8 Ω·cm 2 ,主要用于微波射频、氮化镓晶体管等领域。 
针对半导体行业应用的 SiC 晶圆划切,主要有砂轮划片、激光全划、激光半划、激光隐形划切、水导激光划切等几种加工方法。半导体封装工程师之家介绍了每种方法的特点及应用,分析后认为激光隐形划片与裂片结合的加工方法,加工效率高、工艺效果满足生产需求,是SiC晶圆的理想加工方式。 中泰证券分析师张欣预计,2021年汽车领域SiC有望进入放量元年。该分析师表示,当下的全球 SiC 产业格局呈现美国、欧洲、日本三足鼎立态势,国内企业在衬底、外延和器件方面均有所布局,包括SiC 衬底材料厂商露笑科技、天科合达(天富能源参股 3.7%)、山东天岳(未上市),器件商斯达半导、华润微、扬杰科技、泰科天润(未上市)等;代工龙头三安集成(三安光电子公司) 。 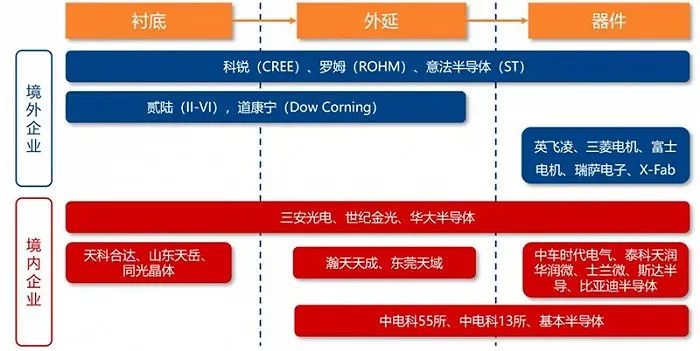
国内公司体量与欧美日本厂商比较均较小,并且在相关工艺和设备问题上面临挑战,但在摩尔定律遇到瓶颈、中国智造2025的大背景下,宽禁带半导体材料,无疑是中国半导体产业实现自我突破一次好机会。当前,中国对于宽禁带半导体材料器件研发正进行针对性规划和布局,其中“十三五”国家科技创新规划、2030计划和“十四五”国家研发计划中都将其作为重点突破方向。 东莞菠菜网址有限公司是一家专业生产金刚石研磨液、纳米级抛光液、抛光垫、超精密研磨抛光材料研发及生产科技型企业,拥有雄厚的专业技术力量,精湛的生产工艺和先进的加工设备,拥有进口检测仪器设备以及优质的服务得到国内高端客户的信赖。 产品广泛应用于半导体、红外晶体、LED芯片、陶瓷、光纤、精密元器件及金属研磨抛光表面精密加工领域。 碳化硅抛光液
产品详情:
碳化硅抛光液利用良好的韧性,在研磨抛光过程中能够保持高磨削力的同时不易产生划伤,针对碳化硅、氮化镓等半导体具有良好的减薄、抛光效果。